特集記事
基板材料・副資材
2016.09.26
銅と窒化アルミニウムセラミクスの新接合技術を開発
基板の窓口編集部

三菱マテリアル(株)は、銀(Ag)を接合材として使用しない、銅(Cu)と窒化アルミニウム(AlN)セラミクスの新接合技術を開発し、AlNセラミクス基板の両面にCuを接合した「AgフリーDBC基板」の試作対応を開始した。
近年、パワーデバイスの高出力密度化に伴い、パワーモジュール用基板及び周辺部材への熱的・電気的負荷は格段に増大している。特に、熱や電気による負荷の高い電気鉄道(電鉄)あるいは直流送電などに使用される電源制御用インバータ向けの絶縁回路基板として、高い熱伝導性・耐圧性を有するAlNセラミクス基板に、回路層として導電性の優れたCuを接合したDBC基板が広く用いられている。同社では、2016年度の電鉄あるいは直流送電用途のセラミクス基板の市場規模を年間約50億円、3年後の2019年度にはその1.4倍となる70億円と推定している。この市場に対し、同社は新技術による「AgフリーDBC基板」の製品開発をさらに進め、2019年度に本格量産を開始し、2020年度には販売目標10億円を目指していく。
基板製造プロセスにおいて、従来技術ではCuとAlNセラミクス基板の接合には、通常、チタン(Ti)などの活性金属を含んだAg系接合材を使用しているが、高湿度環境下で高電圧がかかると、電気化学的な移動現象が起こり、絶縁物表面をAgがシミ状あるいは樹枝状に成長してショートすることがあった。そこで、このたび同社が開発した新技術ではAgを含まない低融点Cu合金 とTiを組み合わせた材料を接合材として使用することにより、こういった問題の解決を含め、次のようなメリットを発揮する「AgフリーDBC基板」の試作対応を開始している。



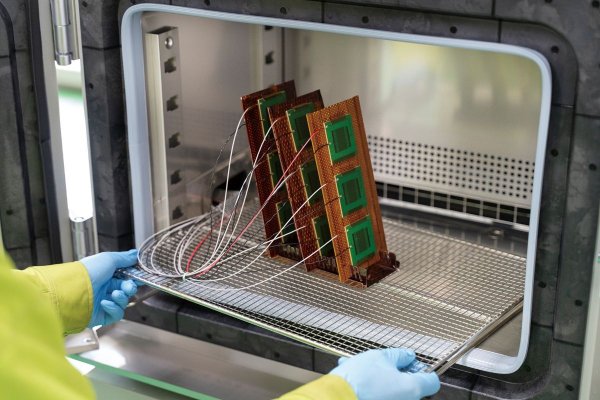



![【見どころ】「第14回 高機能素材 Week[大阪]」 【見どころ】「第14回 高機能素材 Week[大阪]」](https://jpcb.jp/upload/pickup/M/02757_1776314842.png)
