特集記事
実装・パッケージング
2016.06.08
液状封止材の開発技術に関する基本特許の維持が決定
基板の窓口編集部

日立化成(株)は、液状封止材の開発技術に関する基本特許第5720121号について、特許庁による審理の結果、同社による特許維持が決定したと発表した。
封止材は、ノートパソコンやスマートフォンなどのエレクトロニクス製品に使用される電子部品を構成する半導体チップを光、熱、湿気、ほこり、物理的衝撃などから保護するための材料である。
近年、エレクトロニクス製品の小型化、薄型化、低コスト化に伴い、電子部品についても小型化、薄型化、低コスト化が進んでおり、半導体チップの実装方法として、省スペース・低コスト化を図ることが可能なフリップチップ実装が広く採用され、半導体チップとプリント配線板の接続強度を確保することや水分の浸入防止、半導体チップとプリント配線板の隙間を充填することが可能な液状封止材が、フリップチップ実装に使われるケースが増えている。
ただし、フリップチップ実装では、はんだ実装時の過熱によって、液状封止材と半導体チップとプリント配線板の熱膨張率の違いにより、界面剥離が生じる場合があった。
本特許は、界面剥離の発生を抑制できる、ゴム粒子を含有させた液状封止材に関する基本特許であり、当該分野の技術者の注目度が高く、昨年特許取得後に第三者から特許異議申し立てが申請された。しかし、特許庁による審理の結果、このたび同社による特許維持が決定した。



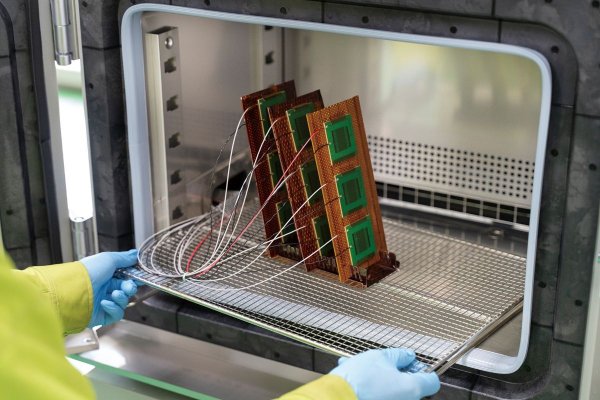



![【見どころ】「第14回 高機能素材 Week[大阪]」 【見どころ】「第14回 高機能素材 Week[大阪]」](https://jpcb.jp/upload/pickup/M/02757_1776314842.png)

