特集記事
半導体実装
〜この1年の半導体市場の動き(その①)〜
長見 晃

1. はじめに
コロナ禍に引き続き覆われたこの1年であるが、米中摩擦が依然続く中、巣籠もり需要が引っ張って半導体市場は活況を呈する一方、主要半導体工場のいくつかの操業が中断する事態があって、特に自動車用半導体をはじめとして非常に逼迫する状況がいまなお続いている。
自動車工場が操業の一時的中止に追い込まれる事態は、世界的な政治問題となり、いまや世界の半導体製造を大きく担う台湾に増産要請が相次いだとともに、米国、欧州はじめ世界各国・地域で自己完結の半導体製造能力の強化を図っていく動きが盛んに続く現状となっている。
この1年の半導体市場の動きを振り返り、続いて、先端実装に関係する内容をジャンル分けして示していく。
2. 半導体市場のこの1年
2020年10月から2021年9月までに主に注目して、半導体市場の動きを取り出していく。それぞれの時点でのあらわし方である。
■2020年10月
*米国が中国・Huaweiに加えSMICへの輸出規制を厳格化
*「5G」に初めて対応する「iPhone」発表
*米国司法省が「検索で競争阻害」 とする独占禁止法違反でGoogleを提訴
*米国インテルがNANDフラッシュメモリ事業の韓国SK Hynixへの売却を発表
■2020年11月
*最先端の挽回を図るインテルはchiplet実装への取り組みなどの一方、先端生産を外部委託する動き
*アップルが3回目の新製品発表、こんどは注目&待望の自社開発プロセッサ「M1」搭載のMacintoshコンピュータ、「Mac」。
PowerPCからインテルに移行したのが2005年、それから15年経っての自前プロセッサへの移行
*Huaweiはこのほど低価格スマホ事業の売却を発表
*特に10月から目立つ中国の半導体関連プロジェクトの中断あるいは中止
■2020年12月
*2021年の世界半導体販売高は8.4%増の$469,4 billionと、これまでの最高、2018年の$468.9 billionを僅かながら上回る見方
*米国のGAFAはじめ巨大IT、そして新分野を引っ張る注目の各社を巡る様々な動き
*SMICの「エンティティー・リスト」入りの事態を迎える現時点
*「COVID-19」インパクトが圧し掛かってきて、当初の何もわからない段階から「第3波」の渦中に至る現時点
■2021年1月
*自前設計の動きが見られ、公正取引で一層厳しい視線が注がれるGAFAはじめ巨大IT関連の動き
*TSMCへの生産委託、そしてCEO交代とここ数日の間に相次いだインテルの動き
■2021年2月
*時あたかも活況の世界半導体市場の中で、自動車用半導体が不足、各国主要自動車メーカーが減産を迫られる事態に
*コロナ禍の需要増、米中摩擦などで半導体市場が世界的に逼迫
*TSMCが生産増強とともに我が国に後工程R&D拠点を設ける動き
*インテルの新しいCEOにPat Gelsinger氏が就いて、業界に向けた"革新の源泉"になろうと社員への訴え
■2021年3月
*Biden大統領が半導体supply chainの弾力性を高める手段を講じる大統領令に署名
*EUそして各国で同様の先端半導体の自己完結を図る動き
*中国の半導体業界団体、CSIAが米国・SIAに対し摩擦緩和に向けた半導体working groupの設立を働きかけ
*米国Texas州での大寒波による停電から、Samsungの工場が止まる
*要因が重なって世界中で深刻な需給不均衡と、自動車用半導体はじめ混乱の事態
*ルネサスエレクトロニクスでの火災が、世界のsupply chainに重なるインパクト
*インテルの最先端はもちろんファウンドリー対応を前面に押し出した"IDM 2.0"戦略
■2021年4月
*米国Biden政権が8年間で2兆ドル(約220兆円)規模のインフラ投資計画を議会に提案
*深刻さを増すグローバルな半導体の不足の問題を話し合うvirtual meetingをWhite Houseが主催
*TSMC創業者で前トップのMorris Chang(張忠謀)氏からの思いの丈を放ったと受け止める講演
■2021年5月
*TSMCから米国での工場展開とともにファウンドリー対応は台湾でと牽制するスタンス
*IBMの世界初、2-nm半導体の披露
*米国の半導体会社および主要ユーザの分野横断alliance、Semiconductors in America Coalition(SIAC)が結成
*日米連携で打開を図るべく自民党そしてJEITAから具体化に向けた取り組み&提言
*米韓首脳会談にて韓国が米国での投資を発表し、各国・地域の競合にも似た状況模様
■2021年6月
*我が国でも、政府、経済産業省、自民党そして業界と、それぞれ成長戦略の検討&打ち上げ
*自国内での半導体製造およびsupply chainの強化が、国家事業の色合いを濃くして、各国各様に展開
*インテルは、今年2月に復帰就任したCEO、Pat Gelsinger氏が新体制を発表
■2021年7月
*本年の半導体販売高$500 billion突破の予測が繰り返されるとともに、2023年には$600 billionをも突破の見方
*インテルはTSMCへの米国政府の補助金に異議を唱える主張
*Morris Chang氏が、各国の半導体自給自足への動きに警鐘
*TSMCは日本での工場建設の検討をさらに明らかにし、Samsungも米国での新工場の検討
■2021年8月
*インテルが、今度は半導体生産に関するロードマップ説明のオンラインイベント「Intel Accelerated」を開催、2025年には業界を先導する内容の展開
*$1 trillionインフラ法案が米国上院を通過、
*自動車用半導体の不足が来年まで尾を引く見方が依然あらわされる
*Hot Chipsが、新型コロナのために昨年に続いて今年もオンライン開催
■2021年9月
*インテルが欧州で2つのfabsの構想打ち上げ、そしてSamsungの米国fabの立地選定
*欧州の台湾との関係強化および自給体制の構築に向けた「欧州半導体法」の制定を目指す動き
*一方、需要一巡の兆しも
*Biden政権が半導体、自動車の業界関係トップとのvirtual White House meetingを開催。
商務長官が不足の状況について45日以内の情報提供を求める
米中摩擦がかぶさる中での日進月歩の激しい動きとなっており、2021年2月あたりから自動車用半導体の不足が表面化、Samsungそしてルネサスエレクトロニクスの工場操業中断が輪をかける状況がうかがえている。
基幹産業の自動車に減産の事態を招いて、各国・地域が他に頼らない半導体製造の強化に相次いで取り組んでいる動きが頻繁にあらわれている。
大変逼迫した状況の半導体市場は、その旺盛な需要から2021年の世界半導体販売高が、これまでの最高の2018年を上回る勢いを示している。
米国・Semiconductor Industry Association(SIA)が毎月はじめに発表している月次世界半導体販売高を、2018年1月から示すと●表1の通りである。

2016年後半から2年あまりメモリ半導体の高値が大きく引っ張って史上最高を更新し続ける勢いの熱い活況が続いた半導体業界であり、2017年には年間半導体販売高が初めて$400 billionの大台を突破して、2018年では$468.94 billionと最高を記録している。
2018年3月あたりから火がつき始めた米中通商摩擦が、双方の応酬を重ねていって半導体の世界にも微妙な懸念要因となり、米国政府が中国テレコム最大手、Huaweiへの輸出制限を厳格化、そして中国最大の半導体ファウンドリー、SMICも含める様相となって、冒頭に示す2020年10月の動きに続いていく。
2021年各月の販売高は、2018年をそれぞれ大きく上回っており、このままいけば、年間販売高が史上最高を更新することになるが、2021年8月あたりからDRAM価格が下げに転ずる兆候が見られ、巣籠もり需要が一巡かとの見方があらわれてきている。
予断を許さない中、今後の動きに注目せざるを得ない現時点である。
3. 先端実装関連の動き
引き続く激動の中、エレクトロニクス・半導体業界は、新しい要素技術、プロセス技術を駆使した新しい分野の開拓、展開が依然旺盛に行われて、市場需要を大きく支えている。
伸びが減速したとはいえ、大規模な世界市場を維持するスマートフォンに加えて、Internet of Things(IoT)、データセンター、自動運転車、スマートエレクトロニクスなどの新しい分野が、人工知能(artificial intelligence:AI)、深層学習(deep learning)はじめ要素技術の目覚ましい深化、高度化から市場のより大きな一角を担うようになっている。
このような状況の中、先端実装関係でも引き続き、
○ 新分野の高性能化、高機能化に向けた貫通電極(TSV:Through Silicon Via)、シリコンインターポーザ、chipletなどを駆使したSystem in Package(SiP)化のアプローチ
○ 3D NANDに代表されるメモリ半導体での多層化による大容量化の継続進展が前面に出て、それぞれ大きく引っ張る技術そして業界模様が続いている。
Moore則後の進化、展開の実現手段の大きな1つとして先端実装へ注目度が一層高まってきているこの1年の動きを次のように項目分けしてまとめている。
・ 技術および市場評論
・ 国際会議および展示会
・ 3D NANDはじめメモリ関係
・ 各社・機関の取り組み
・ 政府・業界関連の動き
・ 研究関連
2020年10月から2021年9月までの動きについて、以下、それぞれ基本時間順に示していく。
1.技術および市場評論
先端実装市場の規模の見方があらわされている。
◎Advanced Packaging Market to Witness Steady Growth of 8% During 2020-2026 (10月8日付け SEMICONDUCTOR DIGEST)
→Global Market Insightsの最新調査。先端実装市場が、現在の$25 billionを上回る規模から2026年までに$40 billion超に延び、著しい牽引力を得ていく。
◎Advanced packaging to have 31% CAGR 2019-25
-Yole: Advanced packaging on pace to reach $4B by 2025(11月5日付け Electronics Weekly(UK))
→Yole Développement発。high-end実装市場が、2019年と2025年の間で31%のCAGR、2025年までに$4 billionを上回る規模に達する。

◎Emerging Apps And Challenges For Packaging
-Heterogeneous integration advances, slowly yet surely
(11月23日付け Semiconductor Engineering
→車載electronics, サーバおよびスマートフォンにおけるheterogeneous integrationに向けた先端IC実装の開発が受け入れられてきているが、complexityおよびコストが依然課題。Yole Developpementは、昨年の先端実装市場が$29 billionの規模と評価、年に6.6%増大して5年で$42 billionになると予測。
◎North America Advanced Packaging Market 2026
- A $5 Billion Revenue Opportunity(1月20日付け SEMICONDUCTOR DIGEST)
→Graphical Research発。
北米先端実装市場売上げが2019年に$3 billionを越え、2026年までに5 billion-dollar台に達する見込み、2020年から2026年の間に7%/年で伸びていく。
◎ Advanced packaging market growing 6.6% CAGR to reach $42bn in 2025
-Yole: Advanced packaging market to hit $42B in 2025 (3月1日付け Electronics Weekly(UK))
→Yole Developpementの予測。先端実装市場が、2019-2025年の間6.6%のCAGRで伸びて、2025年には$42 billionに達すると見る。
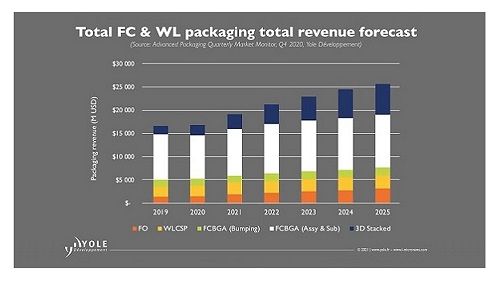
◎3D Semiconductor Packaging Market Growth Opportunities in the Forthcoming Years with Forecast to 2023 (6月16日付け SEMICONDUCTOR DIGEST)
→Market Research Future(MRFR)の最新レポート。
グローバル3D半導体実装市場が、2023年末までに$37,472.7 millionの規模に達する様相、健全な成長率を反映の旨。
3D半導体実装は革新的な技術であり、いくつかの利点がある。
半導体をコア単位で製造して後からレゴブロックのように合体させることで1つの製品をつくり出す方式、chipletが、やはり最も注目のキーワードであり、さまざまな切り口の評論が見られている。
◎Protecting Chiplet Architectures With Hardware Security
-Chip disaggregation means a larger attack surface, increasing the chances of a successful trojan or man-in-the-middle attack.(10月8日付け Semiconductor Engineering)
→Rambus Securityのtechnical director、Scott Best氏記事。
chipletsは、半導体性能、コストおよびtime to marketを進める上で動かずにはいられない利益を与えることで、大きな牽引力を得ている。
Moore's Lawが鈍化、より強力な半導体の構築はより大きな半導体の構築になっていく。
しかし半導体寸法がreticle限界を押しやって、半導体の大きさの伸びはますます実用的でない。
chipletsは、大きいmonolithic integrated circuits(ICs)をより小さなpiecesに分解して新しい道筋が得られ、system-in-package(SiP)で一緒に利用できる。
◎Explainer on Packaging: Interposers, Bridges and Chiplets
(11月10日付け EE Times)
→IC業界が先端実装への重点化を更新しており、chipletsは最も熟さない選択肢であるが、最も広く行き渡る1つでもある。
◎Designs Beyond The Reticle Limit
-Big, complex chip designs exceed reticle limits
-Chips are hitting technical and economic obstacles, but that is barely slowing the rate of advancement in design size and complexity.(11月12日付け Semiconductor Engineering)
→IC設計の複雑度および寸法が増大、technologistsが先端photolithographyで用いられるreticlesによる物理的制約を越える問題を扱っている旨。
「代表的には、設計が粗いレベルで2.5D chiplet境界にわたって分割されると見ている。」と、Armのvice president of technology and fellow、Peter Greenhalgh氏。
◎Apple M1 Processor, Passing on the Chiplets (11月13日付け EE Times)
→今週のAppleのM1プロセッサ発表に照らして、Appleがなぜchipletsを通り過ぎたか、chipletsはどこで理に適うか、考えたい。
◎Chiplets For The Masses
-Analysis: Chiplet tech moves from the few to the many
-Chiplets are technically and commercially viable, but not yet accessible to the majority of the market.
How does the ecosystem get established? (3月3日付け Semiconductor Engineering)
→chiplet技術は、選ばれた数少ない半導体会社に限られて、chipletsの採用 が広まるには強力なecosystemおよび業界標準が必要となる旨。
「健全な技術的考え方であり、動きを起こそうとしている団体がある。」と、Ansysのdirector of product marketing、Marc Swinnen氏。
◎Chiplets: A Short History (3月14日付け EE Times)
→用語がいつ普及するようになったか、考えるのに、Google Trendsは2004年に遡る検索用語としてchipletの歴史を与えている。
chipletで初期のちょっとの手出しがあったが、すばやく消えて、本当に上がってきたのは2019年以降。
◎More than Chiplets | Facebook Enters the Fray (3月16日付け EE Times)
→Facebookによるデータセンター向けハードウェアの仕様や設計図を公開するプロジェクト「Open Compute Project(OCP)」。
Chipletsが、OCPのsubgroup, Open Domain Specific Architecture(ODSA)に属し、programmableデバイスも研究されている。
◎Waiting For Chiplet Standards
-Chiplet standards are starting to emerge
-An ecosystem is required to make chiplets a viable strategy for long-term success, and ecosystems are built around standards. Those standards are beginning to emerge today. (3月25日付け Semiconductor Engineering)
→chiplet技術が、業界標準が開発されていてより多くのユーザにchipletsを利用できるようにするところまで成熟してきている旨。
「このことはこの領域で各社が見るたくさんの課題を緩和していく本当のopportunityである。」と、CHIPS Allianceのexecutive director、Rob Mains氏。
◎CEO Outlook: Chiplets, Longer IC Lifetimes, More End Markets
-Experts discuss chiplet tech, other topics
-How the end of scaling and the electrification of everything are changing chip design.
(7月14日付け Semiconductor Engineering)
→半導体業界のトップexecutivesの7人がchiplet使用、末端市場およびIC長寿命化を議論するroundtable interview。
「我々のたくさんのパートナーが、複雑性増大への対応、およびかつてない高効率のシステムを構築する方法としてchipletsに非常に興味を持っている。」と、ArmのCEO、Simon Segars氏。
◎Piecing Together Chiplets
-Overcoming the challenges of chiplets
-Changes that could push this packaging approach into the mainstream, and the challenges ahead. (7月22日付け Semiconductor Engineering)
→chiplet技術の使用が、半導体業界においてより普通になってきている旨。「来年はchiplet設計の数が増えていく。」と、TechSearch Internationalのpresident、Jan Vardaman氏。
◎EXPLAINER-Intel banks on 3D chip technology to win over new customers (7月26日付け Reuters)
→半導体製造における最新の競争として、単一の大きな半導体をつくろうとするのではなく、取り出した微小なsquares、“chiplets”あるいは“tiles”の重ね合わせである。
◎Challenges With Chiplets And Packaging
-Experts discuss advanced packaging, chiplets, and more
-Experts at the Table: The impact of optics, copper hybrid bonding, more standardized interconnects, and many other technologies under development. (9月15日付け Semiconductor Engineering)
→先端IC実装, chiplets使用, interconnects, copper hybrid bondingおよびopticsなどいろいろな話題を5人の業界エキスパートが話し合うroundtable interview。
「chipletsに進むと、最初の応用がhigh-endシステムになっていくのは明らか。」とPromexのPresident and CEO、Richard Otte氏。
「すべてcustomになっていく。」
先端実装の現状および課題についての見方が、いろいろあらわされている。
◎Defect Challenges Grow For IC Packaging
-Defects emerge in advanced chip packaging
-New equipment will help, but it's expensive and requires more steps. (10月22日付け Semiconductor Engineering)
→先端IC実装が新たないろいろな欠陥に悩まされており、次世代検査装置の開発を必要とする。
◎Designing 2.5D Systems
-2.5D IC designs create new challenges
-Connecting dies using an interposer requires new and modified processes, as well as organizational changes.(3月15日付け Semiconductor Engineering)
→2.5D半導体設計におけるシリコンインタポーザ使用など先端実装技術の採用増大から、新しいビジネス、組織的および技術的課題一式があらわれている。
「2D設計とまったく同様、初期floorplanningを行わなければならないし、architectは何が下流でやってくるか気づく必要がある。」と、Cadence Design Systemsのsenior director, product management、Vinay Patwardhan氏。
◎What Goes Wrong In Advanced Packages
-The challenges of advanced IC packaging
-More heterogeneous designs and packaging options add challenges across the supply chain, from design to manufacturing and into the field.(3月24日付け Semiconductor Engineering)
→microchipsに向けた先端実装の種類の広がりで、複雑性増大、lifetimesの変化および独特の設計によりいくつかの問題が示される旨。
「標準が、high volume達成に向け、そして不具合へのインパクトを高めるのに必要となる。」と特に言及するSynopsysのpackage design engineer、Kent Stahn氏。
◎3D Stacking For Performance And Efficiency
-Testing the feasibility and readiness of high-density, face-to-face, wafer-bonded 3D stacking technologies.(4月8日付け Semiconductor Engineering)
→Moore's Law scalingが鈍化、あるプロセスnodeから次への性能、power, area, およびコストの改善が抑えられる旨。
結果として、先端実装および3D stacking技術が次世代高性能高エネルギー効率設計に向けたkey driversとして最前線に出てきている。
◎DRAM Destined to be 3D
-3D DRAM will be different than 3D NAND from a materials perspective(5月11日付け EE Times)
→数年かかるかもしれないが、DRAMがNANDの歩みに従って3Dに向かう様相、コスト効率良く行うには新しい製造装置および材料が必要になる旨。
◎Advanced Packaging's Next Wave
-The next wave in advanced packaging technology
-A long list of options is propelling multi-chip packages to the forefront of design, while creating a dizzying number of options and tradeoffs(5月20日付け Semiconductor Engineering)
→先端実装技術が、IC組立&テスト会社で使われてきている旨。
「microbumpsがstackingに向けて使えるには、個々の高さおよびdie-level coplanarityが非常に正確、高精度に測られなければならない。」と、Onto Innovationのdirector of thin films product management、Priya Mukundhan氏が論文にて。
◎Bumps Vs. Hybrid Bonding For Advanced Packaging
-Advanced packaging tech: Hybrid bonding or bumps?
-New interconnects offer speed improvements, but tradeoffs include higher cost, complexity, and new manufacturing challenges.
(6月23日付け Semiconductor Engineering)
→先端IC実装技術の実行において、半導体メーカーはinterconnectに向けて従来のcopper microbumpsとcopper hybrid bondingの間の選択となる。
「重要課題の1つとして、特にbondingプロセスの間に低温化bondingおよびalignment精度改善を要する応用について、コスト効率の良い統合方式の発案がある。」と、Lam Researchのmanaging director of the advanced packaging business segment、Manish Ranjan氏。
◎Advanced Packaging Technologies Overcoming the Memory System Performance and Capacity Limitation (7月21日付け EE Times)
→SK hynixのHo-Young Son, Ph.D.氏による先端実装技術に焦点を当てた記事。
以下の項目:
Rethinking packaging technology
Memory Capacity Demands Impact Chip Technology
Balancing Capacity and Heat Generation
Transforming Packaging for Growth
◎WF6 and NF3 Demand Expected To Outstrip Supply By 2025 Driven By 3D NAND Memory Evolution
(8月10日付け SEMICONDUCTOR DIGEST)
→TECHCET発。
3D NANDメモリの進化で、WF6(tungsten deposition)、NF3(chamber clean gases)、および重希ガス(KrおよびXe)の使用増加が引っ張られ、供給不足につながる可能性がある。
◎Current And Future Packaging Trends
-Experts discuss trends in advanced packaging
-Experts at the Table: Rising costs and the physical limits of reticles is forcing more companies to examine alternatives to shrinking geometries. (8月19日付け Semiconductor Engineering)
→業界エキスパート5人がIC実装の最新の開発について語るroundtable interview。
「bigプレイヤーが、実装の役割を実現している。」と、EV Groupのdirector of business development、Thomas Uhrmann氏。
次章「国際会議および展示会」以下は、「その②」でご紹介する。